Critical Dimension Measuring

nXD-1
High-resolution optical system
150㎚ resolution, real-time 2D/3D measurement solution
of micro-patterns to overcome the diffraction limit
of micro-patterns to overcome the diffraction limit
nXD-1 overcomes the inherent measurement limitations of conventional optical
structures. Due to the diffraction limit, CD line widths of 1 ㎛ or less were measured
only by a scanning electron microscope, which requires special equipment. However, nXD-1 uses an optical system and algorithm to get over the diffraction limit
and accurately measure a line width of 1 ㎛ with an optical resolution of 100 ㎚.
If you need to measure CD line width of 1 ㎛ due to the miniaturization and
high integration of semiconductor chips, measuring with the non-destructive
optical structure will open up a new horizon. In addition, if you need to measure a fine line width made by using a Femto laser
in the display process, nXD-1 can be the best tool to increase the stability of
the process and deliver precise measurement. Thus, it will usher in a new paradigm
in the measurement market to solve the issues of precise measurement
at the borderline between optical systems and electron microscopes.
structures. Due to the diffraction limit, CD line widths of 1 ㎛ or less were measured
only by a scanning electron microscope, which requires special equipment. However, nXD-1 uses an optical system and algorithm to get over the diffraction limit
and accurately measure a line width of 1 ㎛ with an optical resolution of 100 ㎚.
If you need to measure CD line width of 1 ㎛ due to the miniaturization and
high integration of semiconductor chips, measuring with the non-destructive
optical structure will open up a new horizon. In addition, if you need to measure a fine line width made by using a Femto laser
in the display process, nXD-1 can be the best tool to increase the stability of
the process and deliver precise measurement. Thus, it will usher in a new paradigm
in the measurement market to solve the issues of precise measurement
at the borderline between optical systems and electron microscopes.
Key Features
· Measurement
of fine line width (1㎛)
of fine line width (1㎛)
· Fast measuring and data acquisition
· High precision
· High precision
· Simple measurement process
· Easy user interface
· Minimum installation space
· Easy user interface
· Minimum installation space
Critical Dimension Measurment
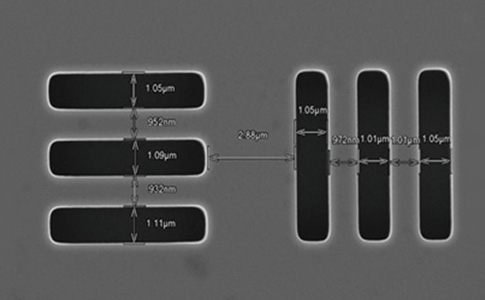
SEM

nXD-1 (50x)

General microscope (50x)
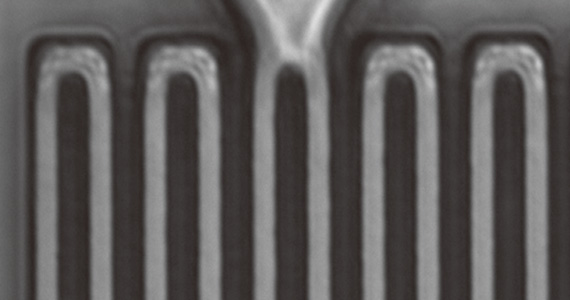
nXD-1 (50x)

General microscope (50x)
Specifications
Request a specification
Contact us
Latest News
Request a sample test
Request a sample test now!
You can experience the technology of Nexensor.
You can experience the technology of Nexensor.
Contact us
| Measuring model | Measuring technology | Test content | Measuring data |

|
Large-area measurement with WSI interferometers FOV extensive application | Micro Bump Height Monolayer membrane thickness measurement PCB fine pattern Processed surface roughness measurement Sensor step-difference measurement |
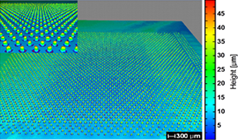
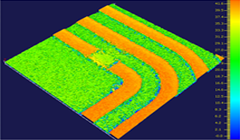

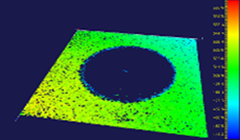

|

|
Free-Form Metrology
Divided inspection possible according to product curve angels
|
Inspection of lens and glass, and measurement of shapes
Inspection of OLED surfaces, and measurement of shapes
Inspection of wafer surfaces, and measurement of shapes
|
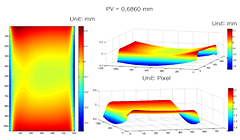



|

|
Real-time measurement of transparent and semitransparent product thickness
Applicable to multi-channels
|
Measurement of wafer(silicone, sapphire) thickness
Measurement of glass and film thickness
|

|






